×
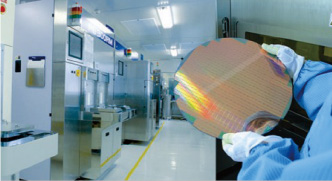

作用:晶圆减薄是将晶圆(wafer)进行背面研磨以减薄,达到封装需要的厚度。
设备型号:TSK PG3000RM


作用:晶圆切割是将晶圆上的一颗颗晶片(Die)切割分离。
设备型号:TSK AWD-300TXB & Disco DFD6361


作用:将一颗颗晶片置于框引线框或基板上,并用银胶(Epoxy)黏着固定。
设备型号:Hitachi DB-830 Plus


作用:利用高纯度的金线铜线或合金线把晶片的焊盘与基板的焊盘或引线框的I/O引线焊接起来。
设备型号:K &S Iconn


作用:将前端完成焊线的晶片密封起来,保护晶片及焊线,避免受损、污染和氧化。
设备型号:Towa Auto Mold Y-1
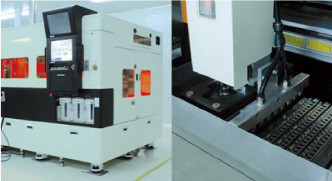

作用:将固定规格的锡球焊接在已经模封的机板上面。
设备型号:AurIgIn Au 800 A Soldier Ball Mounter-Cell 2


作用:将已经封装好的芯片从基板或引线框上独立分出,并形成预先设计好的形状。
设备型号:HAMI semiconductor – 3000; ASM Trim Form MP209
佰维产品自研发、量产至售后服务,各项产品均经过严格且缜密的设计验证,其中包括性能测试、产品安规测试、相容性及稳定度测试、环境和可靠度测试等,层层把关,确保产品具备绝佳和稳定的性能,且符合各项国际认证。
ATACT Command测试NCQ,Trim等命令测试各种平台及OS兼容性测试